
- English
- Español
- Português
- русский
- Français
- 日本語
- Deutsch
- tiếng Việt
- Italiano
- Nederlands
- ภาษาไทย
- Polski
- 한국어
- Svenska
- magyar
- Malay
- বাংলা ভাষার
- Dansk
- Suomi
- हिन्दी
- Pilipino
- Türkçe
- Gaeilge
- العربية
- Indonesia
- Norsk
- تمل
- český
- ελληνικά
- український
- Javanese
- فارسی
- தமிழ்
- తెలుగు
- नेपाली
- Burmese
- български
- ລາວ
- Latine
- Қазақша
- Euskal
- Azərbaycan
- Slovenský jazyk
- Македонски
- Lietuvos
- Eesti Keel
- Română
- Slovenski
- मराठी
- Srpski језик
На основі 8-дюймової печі для вирощування монокристалів з карбіду кремнію
2024-07-11
Карбід кремнію є одним з ідеальних матеріалів для виготовлення високотемпературних, високочастотних, потужних і високовольтних пристроїв. Для підвищення ефективності виробництва та зниження витрат важливим напрямком розвитку є підготовка великорозмірних підкладок з карбіду кремнію. Орієнтуючись на вимоги процесу8-дюймовий монокристал карбіду кремнію (SIC)., було проаналізовано механізм росту карбіду кремнію методом фізичного переносу пари (PVT), систему нагрівання (керівне кільце TaC, тигель з покриттям TaC,Кільця з покриттям TaC, пластина з покриттям TaC, трипелюсткове кільце з покриттям TaC, тигель з трьома пелюстками з покриттям TaC, тримач з покриттям TaC, пористий графіт, м’який фетр, жорсткий повстяний стимулятор росту кристалів із покриттям SiC та іншіЗапасні частини процесу вирощування монокристалів SiCнадано VeTek Semiconductor), було вивчено обертання тигля та технологію керування параметрами процесу в печі для вирощування монокристалів карбіду кремнію, а 8-дюймові кристали були успішно підготовлені та вирощені за допомогою аналізу моделювання теплового поля та експериментів процесу.
0 Вступ
Карбід кремнію (SiC) є типовим представником напівпровідникових матеріалів третього покоління. Він має такі переваги в продуктивності, як більша ширина забороненої зони, сильне електричне поле пробою та вища теплопровідність. Він добре працює в полях високої температури, високого тиску та високої частоти, і став одним із основних напрямків розвитку в галузі технології напівпровідникових матеріалів. Він має широкий спектр застосувань у нових транспортних засобах, що працюють на енергії, виробництві фотоелектричної енергії, залізничному транспорті, розумних мережах, зв’язку 5G, супутниках, радарах та інших сферах. Наразі для промислового вирощування кристалів карбіду кремнію в основному використовується фізичний перенос пари (PVT), що включає складні багатофізичні проблеми зв’язку поля багатофазного, багатокомпонентного, множинного тепло- та масообміну та взаємодії магніто-електричного теплового потоку. Тому конструкція системи росту PVT є складною, а вимірювання та контроль параметрів процесу під часпроцес росту кристалівважко, що призводить до труднощів у контролі дефектів якості вирощених кристалів карбіду кремнію та малого розміру кристала, так що вартість пристроїв із карбідом кремнію як підкладкою залишається високою.
Обладнання для виробництва карбіду кремнію є основою технології карбіду кремнію та промислового розвитку. Технічний рівень, технологічні можливості та незалежна гарантія печі для вирощування монокристалів карбіду кремнію є ключем до розвитку карбідокремнієвих матеріалів у напрямку великих розмірів і високого виходу, а також є основними факторами, що спонукають напівпровідникову промисловість третього покоління до розвиватися в напрямку дешевизни і масштабності. В даний час розробка високовольтних, потужних і високочастотних пристроїв з карбіду кремнію досягла значного прогресу, але ефективність виробництва і вартість підготовки пристроїв стануть важливим фактором, що обмежує їх розвиток. У напівпровідникових приладах з монокристалом карбіду кремнію як підкладкою вартість підкладки становить найбільшу частку, близько 50%. Розробка великогабаритного високоякісного обладнання для вирощування кристалів карбіду кремнію, підвищення продуктивності та швидкості росту монокристалічних підкладок карбіду кремнію та зниження виробничих витрат мають ключове значення для застосування відповідних пристроїв. З метою збільшення постачання виробничих потужностей і подальшого зниження середньої вартості пристроїв з карбіду кремнію одним із важливих шляхів є збільшення розміру підкладок з карбіду кремнію. Наразі міжнародний розмір підкладки з карбіду кремнію становить 6 дюймів, і він швидко зростає до 8 дюймів.
Основні технології, які необхідно вирішити при розробці 8-дюймових печей для вирощування монокристалів карбіду кремнію, включають: 1) Розробку великорозмірної структури теплового поля для отримання меншого радіального градієнта температури та більшого поздовжнього градієнта температури, придатних для вирощування 8-дюймових кристалів карбіду кремнію. 2) Обертання тигля великого розміру та механізм підйому та опускання котушки, так що тигель обертається під час процесу росту кристала та переміщується відносно котушки відповідно до вимог процесу, щоб забезпечити консистенцію 8-дюймового кристала та сприяти зростанню та товщині . 3) Автоматичне керування параметрами процесу в динамічних умовах, які відповідають потребам високоякісного процесу вирощування монокристалів.
1 Механізм росту кристалів PVT
Метод PVT полягає у виготовленні монокристалів карбіду кремнію шляхом розміщення джерела SiC на дні циліндричного щільного графітового тигля, а затравковий кристал SiC розміщується біля кришки тигля. Тигель нагрівається до 2300~2400 ℃ за допомогою радіочастотної індукції або опору та ізольований графітовим фетром абопористий графіт. Основними речовинами, що транспортуються від джерела SiC до затравочного кристала, є Si, молекули Si2C і SiC2. Температуру на затравці контролюють так, щоб вона була трохи нижчою, ніж на нижньому мікропорошку, і в тиглі формується осьовий градієнт температури. Як показано на малюнку 1, мікропорошок карбіду кремнію сублімується при високій температурі з утворенням реакційних газів різних компонентів газової фази, які досягають затравкового кристала з нижчою температурою під впливом градієнта температури та кристалізуються на ньому, утворюючи циліндричну форму. злиток карбіду кремнію.
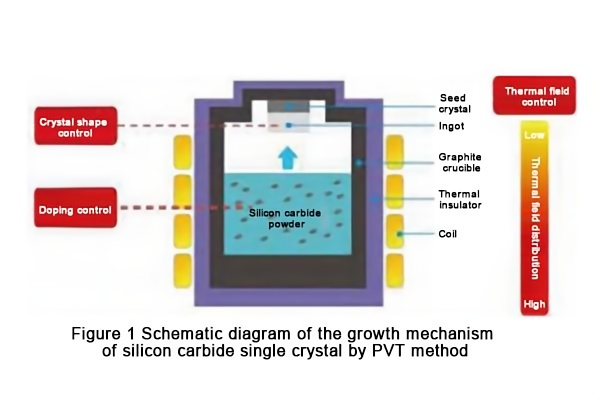
Основними хімічними реакціями росту PVT є:
SiC(s)⇌Si(g)+C(s) (1)
2SiC⇌Si2C(г)+C(s) (2)
2SiC⇌SiC2(г)+Si(l,г) (3)
SiC(s)⇌SiC(г) (4)
Характеристики PVT росту монокристалів SiC:
1) Є дві межі розділу газ-тверде тіло: одна – це межа розділу газ-порошок SiC, а інша – межа розділу газ-кристал.
2) Газова фаза складається з двох типів речовин: один - це інертні молекули, введені в систему; інший компонент - це газофазний компонент SimCn, який утворюється в результаті розкладання та сублімаціїSiC порошок. Компоненти газової фази SimCn взаємодіють один з одним, і частина так званих кристалічних компонентів газової фази SimCn, які відповідають вимогам процесу кристалізації, переросте в кристал SiC.
3) У твердому порошку карбіду кремнію твердофазні реакції відбуватимуться між частинками, які не сублімувалися, включаючи деякі частинки, які утворюють пористі керамічні тіла шляхом спікання, деякі частинки утворюють зерна з певним розміром частинок і кристалографічною морфологією через реакції кристалізації, а деякі частинки карбіду кремнію перетворюються на збагачені вуглецем частинки або частинки вуглецю внаслідок нестехіометричного розкладання та сублімації.
4) Під час процесу росту кристалів відбуваються дві фазові зміни: одна полягає в тому, що тверді частинки порошку карбіду кремнію перетворюються на компоненти газової фази SimCn шляхом нестехіометричного розкладання та сублімації, а інша полягає в тому, що компоненти газової фази SimCn перетворюються на частинки решітки шляхом кристалізації.
2 Конструкція обладнання Як показано на малюнку 2, піч для вирощування монокристалів карбіду кремнію в основному включає: вузол верхньої кришки, вузол камери, систему нагріву, механізм обертання тигля, механізм підйому нижньої кришки та електричну систему керування.

2.1 Система опалення Як показано на малюнку 3, система опалення використовує індукційний нагрів і складається з індукційної котушки,графітовий тигель, ізоляційний шар (жорсткий фетр, м'який фетр) тощо. Коли змінний струм середньої частоти проходить через багатовиткову індукційну котушку, що оточує зовнішню частину графітового тигля, у графітовому тиглі утворюється індуковане магнітне поле такої ж частоти, створюючи індуковану електрорушійну силу. Оскільки матеріал високочистого графітового тигля має хорошу провідність, на стінці тигля генерується індукційний струм, утворюючи вихровий струм. Під дією сили Лоренца індукційний струм з часом буде сходитися на зовнішній стінці тигля (тобто скін-ефект) і поступово слабшати в радіальному напрямку. Завдяки наявності вихрових струмів на зовнішній стінці тигля утворюється джоулеве тепло, яке стає джерелом нагріву системи росту. Розмір і розподіл джоулева тепла безпосередньо визначають температурне поле в тиглі, яке, в свою чергу, впливає на ріст кристала.
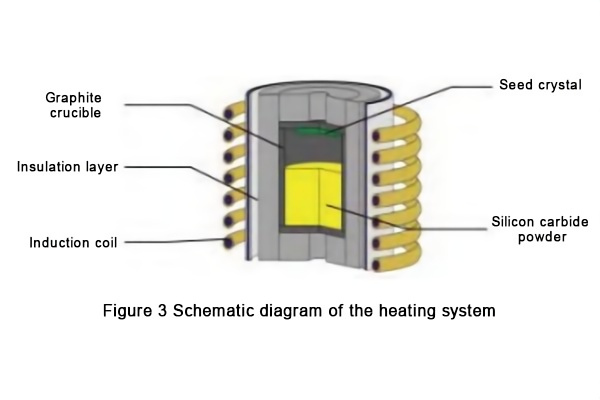
Як показано на малюнку 4, індукційна котушка є ключовою частиною системи опалення. Він використовує два набори незалежних котушкових конструкцій і оснащений верхнім і нижнім точними механізмами руху відповідно. Більшу частину втрат електричного тепла всієї системи опалення несе теплообмінник, тому необхідно виконувати примусове охолодження. Змійовик обмотується мідною трубкою і охолоджується водою всередині. Діапазон частот індукційного струму становить 8~12 кГц. Частота індукційного нагріву визначає глибину проникнення електромагнітного поля в графітовий тигель. Механізм руху котушки використовує механізм гвинтової пари з приводом від двигуна. Індукційна котушка взаємодіє з індукційним джерелом живлення для нагрівання внутрішнього графітового тигля для досягнення сублімації порошку. У той же час, потужність і взаємне положення двох наборів котушок контролюються, щоб зробити температуру на затравочному кристалі нижчою, ніж у нижньому мікропорошку, утворюючи осьовий градієнт температури між затравковим кристалом і порошком у тигля та формування прийнятного радіального градієнта температури на кристалі карбіду кремнію.

2.2 Механізм обертання тигля Під час вирощування великорозмірнихмонокристали карбіду кремнію, тигель у вакуумному середовищі порожнини продовжує обертатися відповідно до вимог процесу, а градієнт теплового поля та стан низького тиску в порожнині повинні підтримуватися стабільними. Як показано на малюнку 5, для досягнення стабільного обертання тигля використовується зубчаста пара з приводом від двигуна. Для досягнення динамічного ущільнення обертового вала використовується магнітна рідинна ущільнювальна структура. Магнітне рідинне ущільнення використовує ланцюг обертового магнітного поля, утворений між магнітом, магнітним полюсним башмаком і магнітною втулкою, щоб міцно адсорбувати магнітну рідину між наконечником полюсного башмака та втулкою, утворюючи рідинне кільце, схоже на ущільнювальне кільце, повністю блокуючи розрив для досягнення мети герметизації. Коли обертальний рух передається з атмосфери у вакуумну камеру, рідке кільце динамічного ущільнювача використовується для подолання недоліків легкого зносу та низького терміну служби твердого ущільнення, і рідка магнітна рідина може заповнити весь ущільнений простір, тим самим блокуючи всі канали, які можуть пропускати повітря, і досягаючи нульового витоку в двох процесах руху тигля та зупинки. Магнітна рідина та опора тигля використовують структуру водяного охолодження, щоб забезпечити високу температуру застосування магнітної рідини та опори тигля та досягти стабільності стану теплового поля.

2.3 Механізм підйому нижньої кришки
Механізм підйому нижньої кришки складається з приводного двигуна, кулькового гвинта, лінійної направляючої, підйомного кронштейна, кришки печі та кронштейна кришки печі. Двигун приводить в рух кронштейн кришки печі, з’єднаний з парою направляючих гвинтів через редуктор, щоб реалізувати рух нижньої кришки вгору та вниз.
Механізм підйому нижньої кришки полегшує установку і знімання великогабаритних тиглів, а головне забезпечує надійність герметичності нижньої кришки печі. Протягом усього процесу в камері є етапи зміни тиску, такі як вакуум, високий тиск і низький тиск. Стан стиснення та ущільнення нижньої кришки безпосередньо впливає на надійність процесу. Як тільки ущільнювач руйнується під дією високої температури, весь процес буде скасовано. За допомогою пристрою керування та обмеження сервоприводу двигуна герметичність вузла нижньої кришки та камери контролюється для досягнення найкращого стану стиснення та ущільнення ущільнювального кільця камери печі для забезпечення стабільності технологічного тиску, як показано на малюнку 6. .
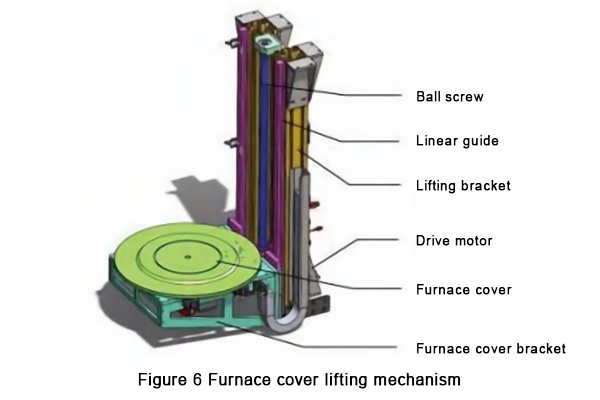
2.4 Електрична система керування Під час вирощування кристалів карбіду кремнію електрична система керування має точно контролювати різні параметри процесу, головним чином включаючи висоту положення котушки, швидкість обертання тигля, потужність і температуру нагріву, різний спеціальний потік газу та відкриття пропорційний клапан.
Як показано на малюнку 7, система керування використовує програмований контролер як сервер, який підключений до сервоприводу через шину для реалізації керування рухом котушки та тигля; він підключений до контролера температури та контролера потоку через стандартний MobusRTU для реалізації контролю температури, тиску та потоку спеціального технологічного газу в реальному часі. Він встановлює зв’язок із конфігураційним програмним забезпеченням через Ethernet, обмінюється системною інформацією в реальному часі та відображає різноманітну інформацію про параметри процесу на головному комп’ютері. Оператори, технологічний персонал і менеджери обмінюються інформацією з системою управління через інтерфейс людина-машина.

Система управління виконує весь збір польових даних, аналіз робочого стану всіх виконавчих механізмів і логічного зв'язку між механізмами. Програмований контролер отримує інструкції головного комп'ютера і завершує керування кожним приводом системи. Виконання та стратегія безпеки автоматичного меню процесу виконується програмованим контролером. Стабільність програмованого контролера забезпечує стабільність і безпечну надійність роботи технологічного меню.
Верхня конфігурація підтримує обмін даними з програмованим контролером у режимі реального часу та відображає польові дані. Він оснащений робочими інтерфейсами, такими як контроль нагрівання, контроль тиску, контроль газового контуру та керування двигуном, і значення налаштувань різних параметрів можна змінювати на інтерфейсі. Моніторинг параметрів тривоги в режимі реального часу, забезпечення відображення тривоги на екрані, запис часу та детальних даних про виникнення та відновлення тривоги. Запис у реальному часі всіх даних процесу, вмісту екрану та часу роботи. Управління злиттям різних параметрів процесу реалізується за допомогою базового коду всередині програмованого контролера, і може бути реалізовано максимум 100 кроків процесу. Кожен етап включає більше десятка параметрів процесу, таких як час роботи процесу, цільова потужність, цільовий тиск, потік аргону, потік азоту, потік водню, положення тигля та швидкість тигля.
3 Аналіз моделювання теплового поля
Встановлено модель імітаційного аналізу теплового поля. На малюнку 8 представлена карта хмари температури в камері росту тигля. Щоб забезпечити діапазон температур росту монокристала 4H-SiC, розрахована центральна температура затравкового кристала на 2200 ℃, а на краю – 2205,4 ℃. У цей час центральна температура верхньої частини тигля становить 2167,5 ℃, а найвища температура порошкової області (стороном вниз) становить 2274,4 ℃, утворюючи осьовий градієнт температури.

Радіальний розподіл градієнта кристала показано на малюнку 9. Нижній латеральний градієнт температури поверхні затравкового кристала може ефективно покращити форму росту кристала. Поточна розрахована початкова різниця температур становить 5,4 ℃, а загальна форма майже плоска та злегка опукла, що може відповідати вимогам до точності радіального контролю температури та однорідності поверхні затравкового кристала.

Крива різниці температур між поверхнею сировини та поверхнею затравкового кристала показана на малюнку 10. Центральна температура поверхні матеріалу становить 2210 ℃, а поздовжній температурний градієнт 1 ℃/см утворюється між поверхнею матеріалу та затравкою. кристалічної поверхні, яка знаходиться в розумному діапазоні.
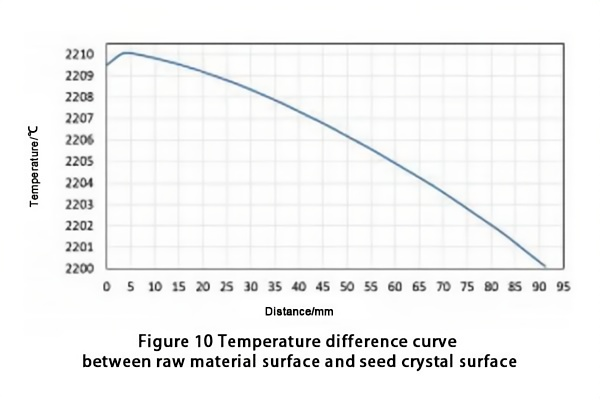
Розрахункова швидкість росту показана на малюнку 11. Занадто швидка швидкість росту може збільшити ймовірність таких дефектів, як поліморфізм і дислокація. Поточна оціночна швидкість росту становить близько 0,1 мм/год, що знаходиться в розумному діапазоні.

За допомогою аналізу та розрахунків симуляції теплового поля виявлено, що центральна температура та температура краю затравкового кристала відповідають радіальному температурному градієнту кристала 8 дюймів. У той же час верх і низ тигля утворюють осьовий температурний градієнт, відповідний довжині і товщині кристала. Поточний метод нагрівання системи вирощування може задовольнити зростання 8-дюймових монокристалів.
4 Експериментальна перевірка
Використовуючи цепіч для вирощування монокристалів карбіду кремніюНа основі температурного градієнта симуляції теплового поля, шляхом регулювання таких параметрів, як температура верхньої частини тигля, тиск у порожнині, швидкість обертання тигля та взаємне розташування верхньої та нижньої котушок, було проведено випробування росту кристалів карбіду кремнію , і був отриманий 8-дюймовий кристал карбіду кремнію (як показано на малюнку 12).

5 Висновок
Досліджено ключові технології вирощування 8-дюймових монокристалів карбіду кремнію, такі як градієнт теплового поля, механізм руху тигля та автоматичне керування параметрами процесу. Теплове поле в камері вирощування тигля було змодельовано та проаналізовано для отримання ідеального градієнта температури. Після тестування метод індукційного нагріву з подвійною котушкою може відповідати зростанню великого розмірукристали карбіду кремнію. Дослідження та розробка цієї технології забезпечують технологію обладнання для отримання 8-дюймових кристалів карбіду кремнію та забезпечують основу обладнання для переходу індустріалізації карбіду кремнію з 6 дюймів на 8 дюймів, покращуючи ефективність росту матеріалів з карбіду кремнію та знижуючи витрати.



